应用笔记
引言
二次离子质谱(SIMS) 是一种用于深入分析薄膜的强大分析工具。 SIMS与其他表面分析技术的区别在于其极高的灵敏度(大多数元素的ppb水平)。 然而,到目前为止,这是有代价的。 在开始分析之前,您需要知道样品结构中的掺杂剂或杂质。 这是因为使用“传统”SIMS深度剖析工具获取深度剖析数据的性质,其中当表面用初级离子束溅射时,所选元素被顺序监测。 基于磁扇区和基于四极杆的质谱仪就是这种情况。 在监视所选元素的同时,所有其他元素都未被检测到。 因此,分析人员有责任全面了解可能的感兴趣元素,以便在分析中对其进行监控。 但是,很多时候这是不可能的。 一名调查员将向SIIMS分析师提交样本说:“我的材料不起作用。 为什么? 有什么内容?“没有给分析师任何可疑的元素进行分析。 经验丰富的分析师通常可以依靠他或她积累的知识来选择可能导致材料失败的元素,但这并不能保证他或她已经正确选择。 可能无法检测到导致故障的元素。
原则
基于飞行时间的SIMS工具可以在开始分析之前了解样本中的内容。 在飞行时间仪器中,用脉冲的极低初级离子通量探测表面以产生二次离子信号。 在数据采集期间,表面实际上是“未溅射的”。 对于每个初级离子脉冲,获取完整的质谱,检测样品中存在的所有元素。 一旦在这种几乎非溅射模式中累积了足够的信号,则使用另一个离子束来溅射材料以暴露由初级离子脉冲探测的新深度。 这种获取深度剖面的方法称为“测量深度剖面”,因为它提供了每个深度间隔的样本的完整调查分析。 在分析之前,人们不必知道样本中的内容,因为每个深度间隔都会检测到每个元素。 此外,在分析多层样品时,材料的溅射去除与二次离子产生的去耦导致了很大的优点,其中界面处的杂质可能是特别重要的。 检测界面处存在的所有元素,并且可以在界面处停止表面的溅射去除并且累积更多数据以获得更好的检测限。 使用“传统”SIMS深度剖析工具,其中溅射通过界面连续,当在界面处检测到一种杂质时,可能会错过另一种感兴趣的元素,因为当质谱仪调谐到它时,溅射可能已经通过该元件可能已经存在的界面。 以这种方式,可以报告假阴性结果。 这在Survey-SIMS深度剖面中不会发生。
示例
图1和2显示SiO的薄膜层结构的Survey-SIMS深度分布2/结晶硅衬底上的多晶硅。数据在两个单独的分析中获得; 电负性物种之一(图1); 和一种正电性物种(图2)。 为了达到最佳检测限,必须分别测量这两个元素组。
在图1中,氧分布(相对于右y轴以强度绘制)显示SiO的存在2 结构顶部的图层。 然而,另外,氧分布显示在多晶硅/晶体-Si界面处和多晶硅层中间的氧化物污染。 这表明多晶硅的两步沉积过程。 砷曲线(以原子/ cc为单位绘制左侧y轴)表明,这种原位As掺杂也积聚在相同的两个界面以及SiO上2/ poly-Si接口。 还有证据表明,一些As已经从重掺杂的多晶硅层扩散到下面的Si衬底中。
还检测到所有这三种界面的氟和碳。 图的标题。 1列出了在这种材料系统中常见的电负性元素的检测限。
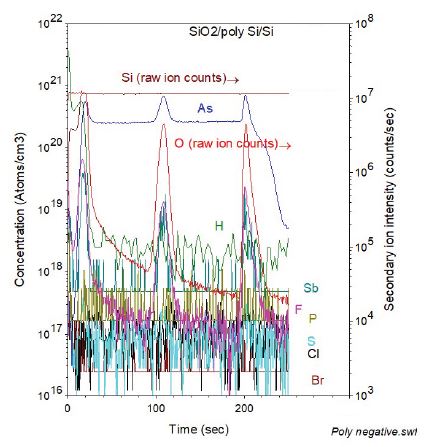
图1 在SiO的薄膜层结构中的电负性元素的Survey-SIMS深度分布图2/结晶Si衬底上的多晶硅。

表1 通过Survey-SIMS深度剖析检测电负性元素的限值。
图2显示了在相同结构上获得的正电性元件的轮廓。 在图1中检测到F的相同界面处检测到锂,Na,K和Al污染物。 碱金属元素污染可能对器件性能特别有害,如果这些移动物种进入有源器件层,则会导致器件的CV漂移。 存在于这些界面处的Al可以指示在工艺流程中的这些点处沉积的Al金属化层的污染。 碱污染可以来自用于在处理中的这些点处对器件进行图案化的抗蚀剂。

图2 Survey-SIMS在结晶Si衬底上的SiO2 /多晶Si薄膜层结构中的正电性元件的深度剖面图。

表2 通过Survey-SIMS深度剖析检测正电性元件的极限。
在结构中也检测到硼。 多晶硅中的B能级是重要的,因为尽管B的浓度低于As,但B仍将反掺杂As,这是相反的掺杂剂类型,因此减少了As的净n型掺杂。 硼扩散到Si衬底中也将影响在多晶硅下的衬底中的净电掺杂,其中存在As和B.
没有量化的所有其他正电性元素。 它们的检测限列于图中的标题中。
概要
Survey-SIMS深度剖面提供了一种分析材料中掺杂剂和杂质的方法,而无需事先了解它们在被评估结构中的存在。 通过分析电负性和正电性元素(在两个单独的分析中),可以检测周期表中的所有元素,具有出色的深度分辨率和高灵敏度。 一旦识别出感兴趣的元素,人们可能希望用“传统的”磁性扇形或四极杆SIMS深度剖析工具对这些元素进行分析,以获得更好的检测限,尤其是对于大气污染物